| |
IWC PAN - okres od 01.10.2008 do 31.03.2009
W okresie 01.10.2008 - 31.03.2009 w IWC PAN realizowane było zadań dotyczących realizacji
programu kluczowego POIG.01.01.02-00-008/08 pt.
"Kwantowe nanostruktury półprzewodnikowe do zastosowań w biologii i medycynie".
Zadania te można podzielić na cztery zasadnicze grupy:
- rozwój badan i krystalizacja podłoży GaN metodami wysokociśnieniowymi i HVPE (zad. 7 i 8),
- określenie mechanizmu atomowego krystalizacji GaN (zad. 9),
- wyznaczenie podstawowych czynników wpływających na efektywność działania czynnych i biernych
przyrządów optoelektronicznych (zad. 10, 11 13 i 14),
- opracowanie struktur przyrządów elektronicznych opartych na gazie elektronowym 2D - 2DEG (zad. 15).
W ramach realizacji tych zadań uzyskano szereg nowych ważnych wyników naukowych i zanotowano znaczący postęp
technologiczny w szeregu zagadnień. W przypadku planowanej krystalizacji GaN uzyskano podłoża o zaplanowanych
parametrach technologicznych, które zostały przekazane do przeprowadzenia procesów epitaksji w ramach innych
zadań projektu. W procesach krystalizacji wysokociśnieniowej zostały zbadane warunki termodynamiczne
stabilnej morfologicznie krystalizacji na dużych podłożach w różnych konfiguracjach przy uwzględnieniu dużej
anizotropii wzrostu. Przykład płytki otrzymanej podczas krystalizacji w kierunku niepolarnym został pokazany
na rys. 1.
| |
| |
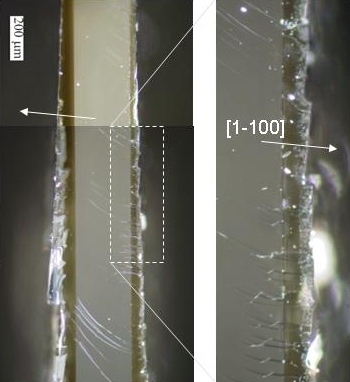
|
|
Rys. 1 Przekrój poprzeczny płytki GaN przygotowanej do wzrostu na orientacji niepolarnej
po obustronnym wzroście wysokociśnieniowym w czasie 30 godzin. Widoczne makroskopowe
stopnie wzrostu będące wynikiem silnej dezorientacji kryształu - zarodzi od nisko-indeksowej
płaszczyzny {10-10}.
|
|
| |
W ramach zadania dotyczącego krystalizacji metodą HVPE zbadano proces osadzania warstw GaN na szafirze,
w celu zastosowania technik redukcji gęstości dyslokacji dla uzyskania podłoży GaN o dużych rozmiarach
i wysokiej jakości krystalograficznej. Ponadto został opanowany proces domieszkowania na typ n podczas
wzrostu metoda domieszkowania krzemem poprzez zastosowanie SiCl2H2.
Uzyskane zostały założone koncentracje elektronów swobodnych w zakresie 2 - 8 x 1018 cm-3
na całym obszarze podłoża. Przykład otrzymanego kryształu GaN o dużych rozmiarach został przedstawiony na rys. 2.
| |
| |

|
|
Rys. 2 Niepolarne płytki GaN o orientacji (10-10) otrzymane poprzez cięcie kryształu GaN
o grubości 5 mm otrzymanego w 4 kolejnych procesach HVPE:
a - kryształ na uchwycie piły diamentowej po pocięciu na niepolarne płytki: szerokość cięcia
i grubość płytek - 400 μm,
b - płytki bezpośrednio po cięciu, zaznaczone obszary "c" i "d" zawierające defekty są
pokazane w powiększeniu na Rys. 2.7 c i d odpowiednio, c - niepolarna płytka po dwustronnym
polerowaniu mechanicznym: jamka nr 1 powstała już w pierwszej warstwie kryształu i odtworzyła
się w każdej następnej, d - inna płytka: jamka 2 jest podobna do jamki 1, natomiast jamka 3
jest wygenerowana dopiero w drugiej warstwie kryształu.
|
|
| |
W zadaniu 9 wykonano szereg obliczeń DFT, dotyczących atomowej struktury powierzchni GaN(0001) w warunkach
typowych dla wzrostu GaN metodami MOVPE i HVPE, a więc w silnym nadmiarze amoniaku. Otrzymane wyniki
wskazują, że na tej powierzchni zachodzi adsorpcja amoniaku bez bariery energetycznej. Ponadto następuje
desorpcja molekularnego wodoru, w procesie charakteryzującym się niską barierą energetyczną, co prowadzi
do powstania pokrycia powierzchni przez rodniki NH2. Niezależnie od tego wykazano możliwość
modelowania procesów wzrostu poprzez włączanie pola elektrycznego w model slabu, co otwiera możliwość
modelowania włączania domieszek podczas wzrostu kryształów i warstw półprzewodników.
W zadaniach 10 i 11 badano mechanizm wbudowywania się atomów Ga, Al., In oraz Si i Mg w zależności
od warunków wzrostu, na powierzchniach polarnych GaN(0001), w warunkach małych odchyleń od płaszczyzny
głównej. Badano wpływ warunków termodynamicznych wzrostu warstw InGaN na ich własności optyczne i elektryczne.
W szczególności został szczegółowo zbadany wpływ obecności wodoru jako gazu nośnego na wbudowywanie się
atomów In i powstawanie stabilnych morfologii powierzchni. Określony został wpływ gazu nośnego i temperatury
wzrostu na powstawanie pinholi i kształtowanie struktury stopni atomowych warstw GaN i InGaN. Przeprowadzono
badania mechanizmu wzrostu w funkcji składu chemicznego gazów i temperatury podłoża. Wykazano że obecność
azotu jako gazu nośnego powoduje powstawanie pinholi w warstwach GaN otrzymywanych w niskich temperaturach.
Dodawanie wodoru powoduje stabilizację wzrostu poprzez powstawanie struktury gładkich równoległych stopni,
lecz jednocześnie zmniejsza zawartość indu w otrzymywanych warstwach InGaN. Przykład struktury powierzchni
otrzymanej metoda pomiaru mikroskopu się atomowych (AFM) jest pokazany na rys. 3.
| |
| |

|
|
Rys. 3. Powierzchnia warstw InGaN (20 nm) wyhodowanego w różnych ciśnieniach i zoptymalizowanych przepływach reagentów.
|
|
| |
Uzyskany rezultat wskazuje, że wzrost na tej orientacji prowadzi do drastycznie zmniejszonej zawartości
In w uzyskanych warstwach, np. uzyskano 2-3 at. %In na płaszczyżnie m, podczas gdy wzrost na płaszczyżnie
c w orientacji galowej prowadzić do uzyskania zawarto?ci 20 at. %In.
W ramach realizacji zadań 13 i 14 prowadzono prace badawcze i technologiczne w celu uzyskania wysoko
wydajnych przyrządów optoelektronicznych, w tym diod laserowych, ich matryc oraz diod superelektroluminescencyjnych.
Otrzymano struktury kształtowane przestrzennie w skali mikro i nano, poprzez odpowiednie formowanie pól naprężeń
jak i poprzez integrację tych struktur w matryce laserowe o wysokiej mocy. Przykład badania ramanowskiego
struktury naprężonej jednoosiowo zostać pokazany na rys. 4.
| |
| |

|
|
Rys. 4. Mapa widm ramanowskich uzyskana przez skanowanie próbki w kierunku prostopadłym do pasków struktury.
|
|
| |
Otrzymano również struktury zintegrowanych pasków laserowych. Rys. 5 pokazuje zdjęcie takiej struktury
wykonane przy pomocy mikroskopu Nomarskiego. Chip laserowy przeznaczony do montażu miał wymiary 1000 x 700 μm.
Zamiast deklarowanych 10 linijek wyprocesowano 11 linijek, co było związane z wymaganiami procesu fotolitografii.
| |
| |

|
|
Rys. 5. Zdjęcie z mikroskopu optycznego elementu laserowego o wymiarach 1000x700 μm.
|
|
| |
W ramach realizacji zadania 15 zostały wykonane badania nad otrzymywaniem struktur HEMT o wysokiej ruchliwości
gazu elektronowego 2-d (2DEG). W szczególności wykonano badania nad uzyskiwaniem buforów GaN na szafirze.
Otrzymane warstwy buforowe GaN o grubości 2,4 mikrona maja bardzo wysoka oporność. Uzyskana koncentracja
nośników jest poniżej 3*1016cm-3 przy jednocześnie małej ruchliwości
(rezystywność >1,5M?cm). Ponadto uzyskano struktury 2DEG na podłożach wysokociśnieniowych o niskiej
gęstości dyslokacji. Przy użyciu pomiaru efektu Halla określono koncentrację i ruchliwość elektronów
2DEG w strukturach HEMT w funkcji temperatury w zakresie od 1.5 K do 300K. W temperaturze ciekłego
helu otrzymano koncentracje w zakresie od 1.2*1012 cm-2 do 5.7*1012 cm-2,
a ruchliwości od 10 000 do 32 000 cm2/Vs w zależności od parametrów technologicznych wzrostu.
|
|

